共用設備検索結果
中分類から探す
表示件数
粉末X線回折装置 (XRD)
- 設備ID
- UT-204
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- ㈱リガク (Rigaku Co.)
- 型番
- SmartLab (Kα1)
- 仕様・特徴
- □ 主な特長
対称ヨハンソン型結晶を用いた光学系による高強度、高角度分解能測定が可能。粉末X線回折等に威力を発揮。
□ 主な仕様
・ X線源:3 kW封入型X線管/Cuターゲット
・ 光学系:集中法・集光法
・ 検出器:シンチレーション検出器:1次元半導体検出器
・対称ヨハンソン型結晶を用いた光学系が可能
・キャピラリー回転測定可能
- 設備状況
- 稼働中
薄膜構造解析用X線回折装置 (XRD)
- 設備ID
- UT-205
- 設置機関
- 東京大学
- 設備画像
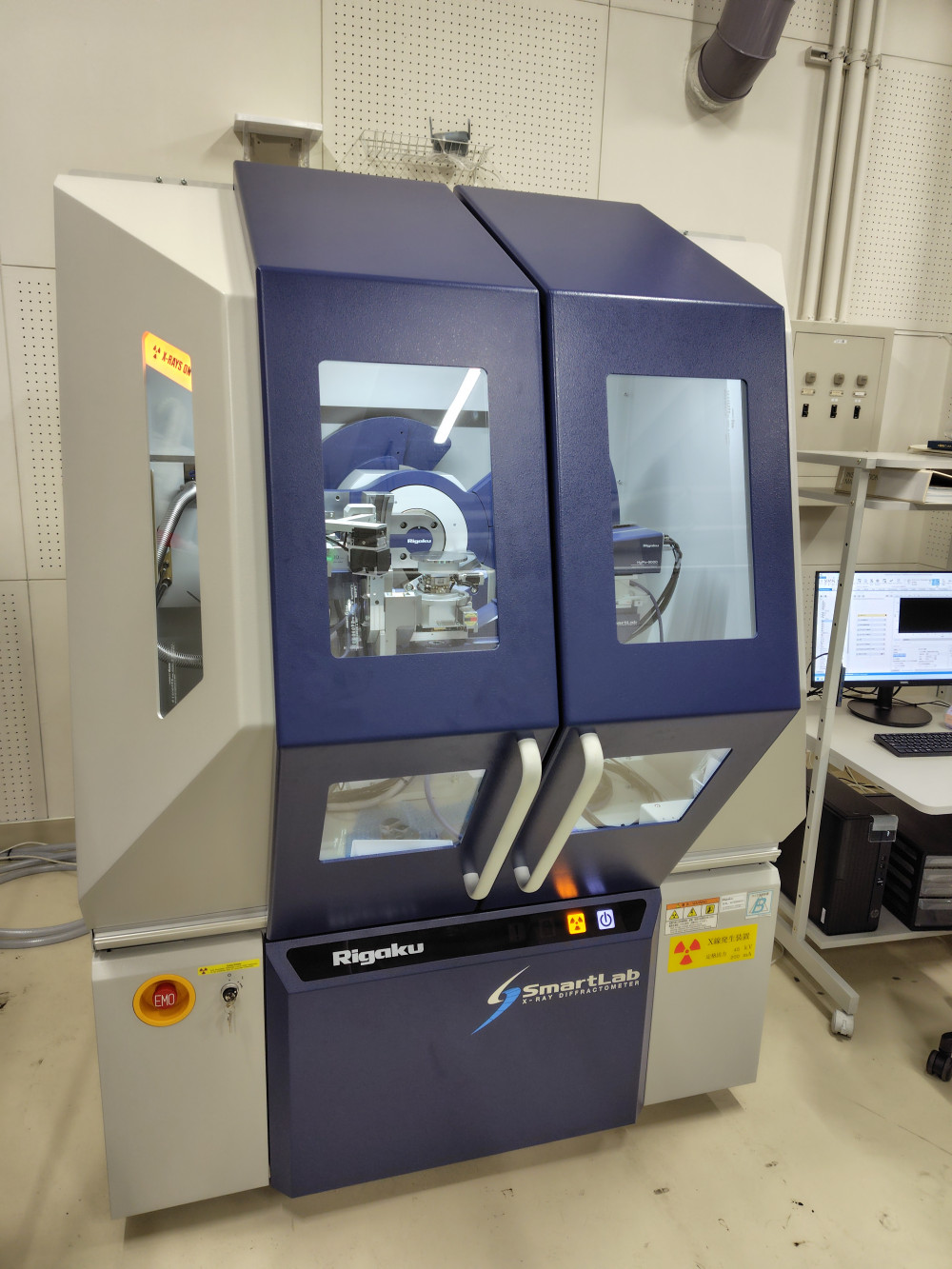
- メーカー名
- ㈱リガク (Rigaku Co.)
- 型番
- SmartLab-XE(9kW)
- 仕様・特徴
- □ 主な特長
・ 高輝度X線源 及び In-Planeアームを搭載した試料水平配置高精度ゴニオメータを使用したX線回折装置。
・ 粉末試料測定に適した集中法光学系,薄膜試料の測定に適している多層膜ミラーを用いた平行ビーム光学系によるX線反射率測定,逆格子マップ測定,ロッキングカーブ測定などを簡単なユニット交換で組み替えて利用することが可能。
・ インプレーンアームの搭載により、極薄膜の評価や完全極点測定が可能。
・微小部光学系と観察用カメラ、X-Yステージにより微小領域測定やマッピング測定が可能
・透過SAXS/WAXS、GI-SAXS/WAXSが可能
□ 主な仕様
・ X線源:9kW回転対陰極X線発生装置/Cuターゲット
・ 光学系:集中法・多層膜平行ビーム法・薄膜高分解平行ビーム法・インプレーン光学系・透過光学系・微小部光学系
・ 検出器:HyPix-3000
- 設備状況
- 稼働中
電子スピン共鳴装置 (Electron spin resonator)
- 設備ID
- UT-302
- 設置機関
- 東京大学
- 設備画像
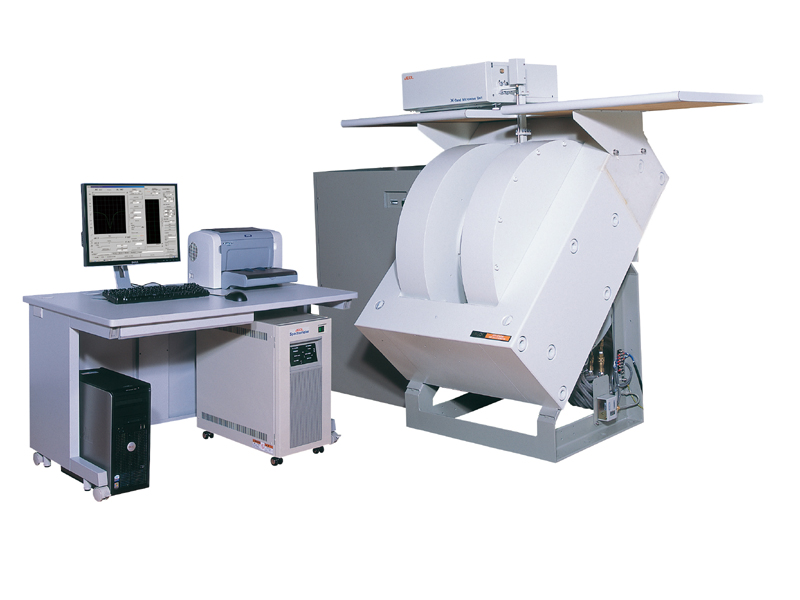
- メーカー名
- 日本電子株式会社 (JEOL)
- 型番
- JES-FA300
- 仕様・特徴
- □ 主な仕様
・ 測定帯域
Xバンド約9GHz/Qバンド約35GHz
・最低計測可能温度 10K以下
□主な用途
・電界誘起キャリア密度・ダイナミクスの評価
・磁気共鳴やg値の磁場依存性の評価
- 設備状況
- 稼働中
分光エリプソメータ (M-2000DI-T)
- 設備ID
- UT-303
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- ジェー・エー・ウーラム・ジャパン (J.A.Woollam)
- 型番
- M-2000U
- 仕様・特徴
- □ 主な仕様
・測定波長:193~1690nm
・チャンネル数:690同時計測
・回転補償子型
- 設備状況
- 稼働中
極限環境下電磁物性計測装置 (Physical Property Measurement System(PPMS))
- 設備ID
- UT-304
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本カンタム・デザイン (Quantum Design Japan)
- 型番
- PPMS-14LHattt
- 仕様・特徴
- □ 主な仕様
・14 T超伝導マグネット
・温度制御 1.9K~400K
・試料空間 25.4mm
□主な用途
・電気輸送特性評価
・磁気特性評価
・熱輸送特性評価など
- 設備状況
- 稼働中
環境制御マニュアルプローバステーション (Environmental control manual prober station)
- 設備ID
- UT-305
- 設置機関
- 東京大学
- 設備画像
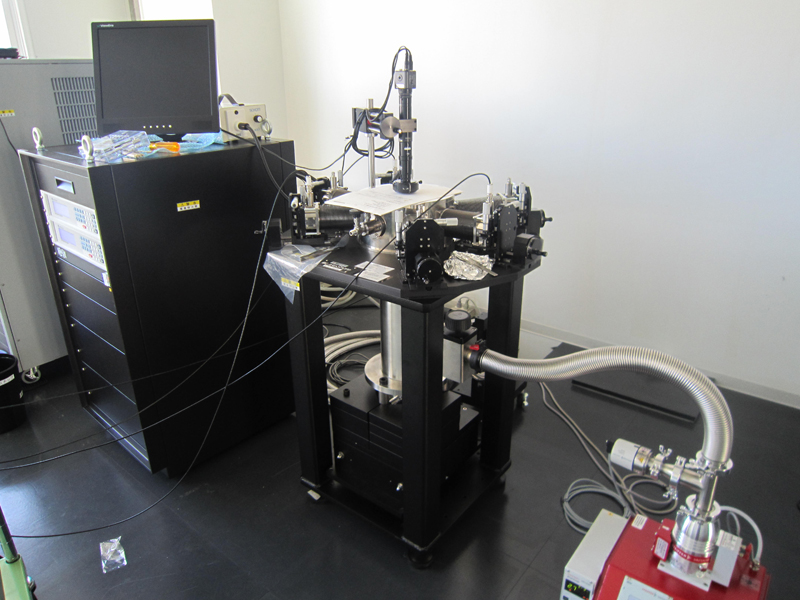
- メーカー名
- (東陽テクニカ等) (Toyo Corporation)
- 型番
- ①半導体特性評価システム4200-SCS ②強誘電体特性評価システムFCE1EEA-200型 ③誘電体インピーダンス測定システム1260 ④極低温プローバー装置CPX-VF
- 仕様・特徴
- □ 主な仕様
・低温プローバ(CRX-4K):6K~350K
・高温プローバ(HCP-401/400):室温~400度
・半導体パラメータ測定(4200-SCS型)
・誘電体測定(FCE1EEA-200型)
・インピーダンス測定(ソーラートロン1260)
□主な用途
・ 強誘電体分極評価測定
・インピーダンス周波数測定
・キャパシタ周波数測定など
- 設備状況
- 稼働中
超微量元素計測システム(SIMS) (SIMS)
- 設備ID
- UT-306
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- カメカ (Cameca)
- 型番
- NanoSIMS 50L
- 仕様・特徴
- □主な用途
微小領域の分析、高空間分解能でのイメージング分析に優れた二次イオン質量分析装置。
□主な用途
・ 一次イオン源:セシウムおよび酸素
・最小ビーム径:50nm (セシウム)
・質量分析計:高性能二重収束型質量分析計
・高感度、高質量分解能での元素・同位体測定が可能。
・最大7種類の二次イオン像の同時検出ができる
- 設備状況
- 稼働中
多機能走査型X線光電子分光分析装置(XPS)with AES (X-ray Photoelectron Spectroscopy with AES)
- 設備ID
- UT-308
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- アルバックファイ㈱ (ULVAC-PHI, Inc. )
- 型番
- PHI 5000 VersaProbe III with AES
- 仕様・特徴
- □ 主な特長
・ 走査型マイクロフォーカスX線源による微小領域分析(最小分析領域10μm)
・ SXI(Scanning X-ray Image)により、正確・迅速に微小な分析位置を特定
・ 低エネルギー電子とイオンの同時照射により、絶縁物試料を容易に帯電中和
・ 5軸(X、Y、Z、Tilt、Rotation)モータ駆動による多点分析
・オージェ電子分光機能がついており、XPSとAESで同一か所の測定が可能
□ 主な仕様
・ 最小ビーム径:10μm以下
・ 最高エネルギー分解能:0.5eV以下(Ag3d 5/2)
・ 最大感度:1,000,000cps(Ag3d 5/2の半値幅1.0eVのとき)
・ 到達圧力:6.7×10-8Pa以下
・ AES最小分析領域:100nm
- 設備状況
- 稼働中
原子直視型超高圧電子顕微鏡 (Ultra-high voltage electron microscope)
- 設備ID
- UT-401
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- 日本電子株式会社 (JEOL Ltd.)
- 型番
- JEM-ARM1250
- 仕様・特徴
- □主な仕様
(1)本体
加速電圧 : 400、600、800、1,000、1,250kV
電子線源 : 単結晶LaB6
焦点距離 : 8.2mm
球面収差係数 : 1.4mm
色収差係数 : 2.5mm
分解能 : 0.1nm(粒子像)
試料最大傾斜角 : ±35°
真空度 : 7×10-6Pa以下(試料室)
排気方式 : ターボ分子、イオン、クライオポンプ併 用(完全ドライ方式)
(2)電子線損傷低減装置(MDS) 組込
(3)画像記録 シートフィルムおよびイメージングプレート(25μm/ピクセル)
(4)収束電子線回折装置 組込
収束角(2α)/最小スポット径 :
4.0mrad./15nm~2.0mrad./30nm
最大加速電圧 : 1,250kV
最大試料傾斜角 : ±25°
- 設備状況
- 稼働中
ウルトラミクロトーム (Ultramicrotome)
- 設備ID
- UT-403
- 設置機関
- 東京大学
- 設備画像

- メーカー名
- ライカバイオシステムズ㈱ (Leica Microsystems K.K.)
- 型番
- EM UC7
- 仕様・特徴
- □特 徴
・静電気式ピックアップ法
・視認性の高LED照明システム
・ユーセントリック動作を搭載した実体顕微鏡
- 設備状況
- 稼働中