共用設備検索結果
表示件数
エックス線光電子分光分析装置(XPS) (X-ray Photoelectron Spectroscopy Analysis System (XPS))
- 設備ID
- AT-074
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- 島津製作所 (SHIMADZU)
- 型番
- KRATOS ANALYTICAL
- 仕様・特徴
- ・型式:KRATOS ANALYTICAL
・試料サイズ: 100 mmφ、, 高さ10mm (専用ホルダ使用で約20mm迄可)
・X線源:Rowland 円直径 500mm モノクロメータ付Al Kα (1486.6 eV)
・光電子分光器:軌道半径165mm 静電二重半球型アナライザー/球面鏡アナライザー複合型
・検出器:ディレイラインディテクター(DLD)システム
・スペクトル分析:100チャネル同時計測
・イメージング:256×256画素(最大分解能3μm)
・最小スペクトル分析面積:15μmΦ
・エネルギ分解能:0.48 eV以下(Ag 3d5/2光電子ピーク半値幅)
・帯電中和 均一低エネルギー電子照射
・光電子取り出し角度:垂直(標準)、0~90°(傾斜観察ホルダ使用)
* 傾斜観察時は試料サイズの制限があります。
・エッチングイオン銃:Ar+、多原子(コロネンC24H12 )イオン
・搭載オプション:He紫外線光源(UPS用 21.2, 40.2 eV)
- 設備状況
- 稼働中
プラズマCVD薄膜堆積装置(SiN) (Plasma-assisted CVD (SiN))
- 設備ID
- AT-081
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- サムコ (Samco)
- 型番
- PD-220SN
- 仕様・特徴
- ・型式:PD-220NS
・試料サイズ:8インチ
・成膜種:SiO2, Si3N4
・電極間隔:25mm (上部電極:Al製、下部電極:SUS製)
・高周波電源:300W(13.5MHz)
・ステージ加熱:350℃(抵抗加熱方式 )
- 設備状況
- 稼働中
化合物半導体エッチング装置(ICP-RIE) (ICP-RIE (Compound Semiconductors))
- 設備ID
- AT-082
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- サムコ (Samco)
- 型番
- RIE-400iPS
- 仕様・特徴
- ・型式:RIE-400iPS
・試料サイズ:4インチ
・放電方式:誘導結合式プラズマ(ICP)
・試料導入方式:ロードロック式
・高周波電源:最大500W (13.56MHz)
・バイアス高周波電源:最大300W(13.56MHz)
・使用ガス:Cl2、BCl3、HBr、Ar、O2、CF4、SF6
- 設備状況
- 稼働中
物理特性測定装置(PPMS) (Physical Property Measurement System (PPMS))
- 設備ID
- AT-085
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
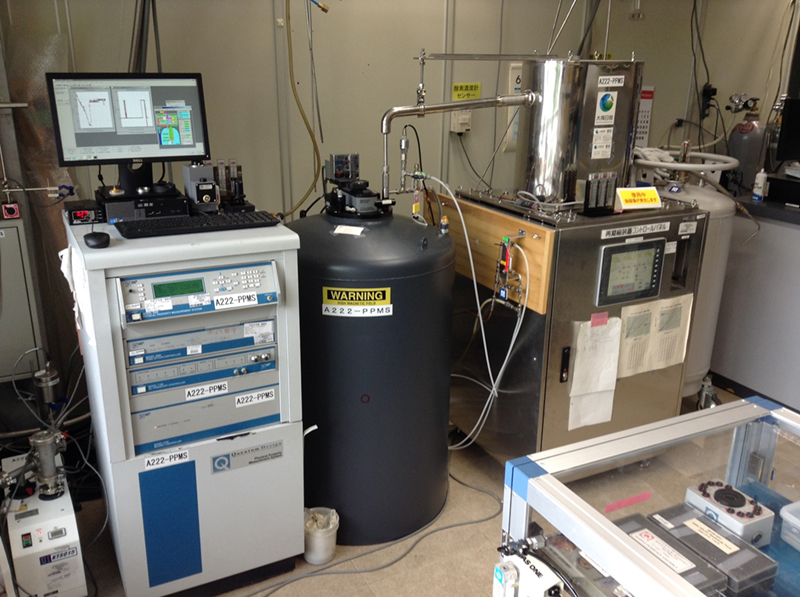
- メーカー名
- 日本カンタム・デザイン (Quantum Design Japan)
- 型番
- MODEL6000
- 仕様・特徴
- ・型式:MODEL6000
・試料サイズ:10mmx10mm
・測定可能温度範囲:1.9~400 K
・温度可変速度:0.01K/分~6K/分
・磁場印加(超伝導マグネット):±14 T(通常は7 Tまで)
・測定機能:直流抵抗測定(DC)、Hall抵抗測定
・交流抵抗測定オプションあり
- 設備状況
- 稼働中
マニュアルウエハープローバー(2F) (Manual Wafer Prober)
- 設備ID
- AT-086
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
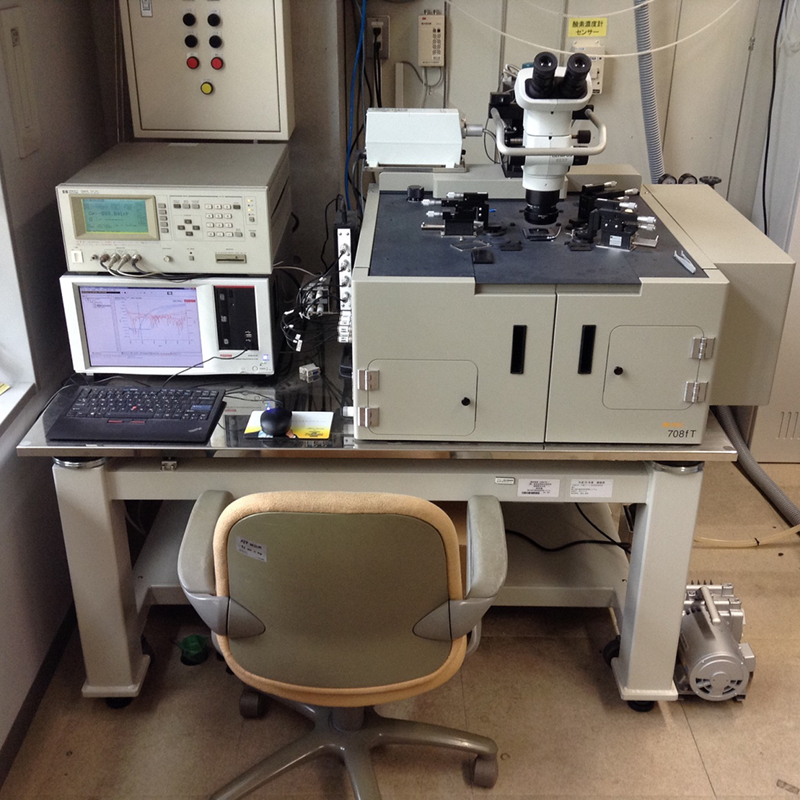
- メーカー名
- MJCKEYTHLEYHP (MJCKEYTHLEYHP)
- 型番
- MJC_708fT-0114200SCSHP4284A
- 仕様・特徴
- ・型式:MJC_708fT-011(マニュアルプローバ)
・試料サイズ:75~200 mmφ、 10~30 mm□
・300 mmウェーハ:中央付近のみ測定可能
・小片試料:0.5インチΦ(専用チャック)
・ステージトラベル:X, Y ±110 mm (取り出し用ストローク含まず)
・サブステージトラベル:X, Y ±5 mm (マイクロメータ駆動)
・Zトラベル:0, 0.3, 3.5 mm固定+3 mm
・プローブ接続:リモートセンシング対応(Force, Sence独立配線)
・プローブ数:3系統+チャックテーブル1系統
・プローブ先端径:R=12.5μm
KEITHLEY 4200-SCS
・SMU搭載数:4200-SMU(4200-PA付き)×4
・電流分解能:0.1fA~100pA
・最大電流:±100mA
・電圧レンジ:200mV~210V(4レンジ)
HP4284A LCRメータ
- 設備状況
- 稼働中
赤外線ランプ加熱炉(RTA) (RTA Furnace)
- 設備ID
- AT-089
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- アドバンス理工 (ADVANCE RIKO)
- 型番
- RTP-6S
- 仕様・特徴
- ・型式:RTP-6S
・試料サイズ:小片~4インチφ
・到達真空度:-4乗Pa台
・加熱方式: 試料上面より放物面反射赤外線輻射加熱方式
・加熱制御方式:プログラム起電力比較クローズドループ・コントロール方式(PID3項制御)
・加熱範囲:150 mmφ
・温度範囲:RT~1000℃
・最大加熱速度:20℃/sec(SiCサセプタ使用時は10℃/sec)
・均熱精度:ΔT=10℃(@700℃保定時 N2ガスフロー中)
・温度センサ:熱電対(シースR熱電対)
・雰囲気 ガス:N2, Ar, O2
- 設備状況
- 稼働中
高圧ジェットリフトオフ装置 ((High Pressure Jet Lift-off Equipment)
- 設備ID
- AT-092
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- カナメックス (Kanamex)
- 型番
- KLO-150CBU
- 仕様・特徴
- ・型式:KLO-150CBU
・試料サイズ:小片20mm□~150mmφ
・回転数:0~2000rpm
・NMP処理温度:80℃
- 設備状況
- 稼働中
高速電子ビーム描画装置(エリオニクス) (Electron Beam Lithography System (Elionix))
- 設備ID
- AT-093
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- エリオニクス (ELIONIX)
- 型番
- ELS-F130AN
- 仕様・特徴
- ・型式:LS-F130AN
・試料サイズ:~12インチφ、9インチ□のマスクブランクス
・電子銃:ZrO/W熱電界放射型
・加速電圧:130kV, 100kV, 50kV, 25kV
・最小ビーム径:1.7nm (@ 130kV)
・最小描画線幅:5nm (@ 130kV)
・最大スキャンクロック:100MHz
・ビーム電流強度:5pA~100nA
・フィールドサイズ:100μm □、250μm□、500μm□、1000μm□(100kV以下)、1500μm□(50kV以下)、3000μm□ (25kV以下)
・ビームポジション:1,000,000×1,000,000 (20bit DAC)
・位置決め分解能:0.1nm
・つなぎ精度:±10nm
・重ねあわせ精度:±15nm
・描画可能エリア:210mm×210mm
- 設備状況
- 稼働中
解析用PC(CAD及び近接効果補正用) (PC (PEC and CAD))
- 設備ID
- AT-094
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像

- メーカー名
- ジェニシス (GenISys)
- 型番
- BEAMER
- 仕様・特徴
- ・型式:BEAMER
・近接効果補正
・パターン分割処理
・輪郭分離処理
・PSFシミュレーション
- 設備状況
- 稼働中
RF-DCスパッタ成膜装置(芝浦) (RF-DC Sputter Deposition Equipment(Shibaura))
- 設備ID
- AT-095
- 設置機関
- 産業技術総合研究所(AIST)
- 設備画像
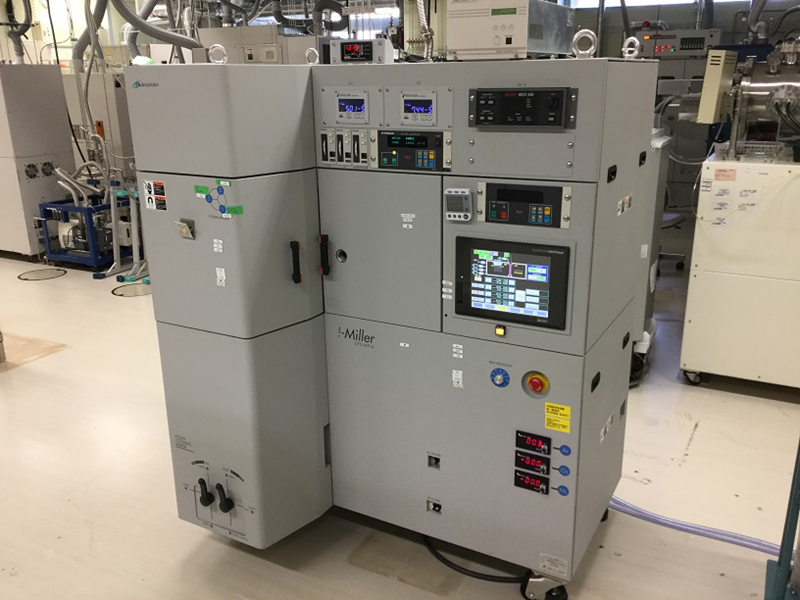
- メーカー名
- 芝浦メカトロニクス (SHIBAURA)
- 型番
- i-Miller
- 仕様・特徴
- ・型式:CFS-4EP-LL、i-Miller
・試料サイズ:8インチ
・スパッタ源:3インチマグネトロン×3式
・スパッタ方式:直流スパッタ、高周波スパッタ
・基板テーブル:回転機構付
・逆スパッタ:200W
・ターゲット-基板間距離:82 mm
・基板加熱:なし
・膜厚分布:±5%以内@膜厚~600nm(SiO2、170 mmφ)
・到達真空度:10-5 Pa台
・スパッタガス:Ar、O2、N2
・成膜時ガス圧(標準):0.5Pa
・常備ターゲット:Al, Al2O3, Au, Cr, Cu, Nb, Pt, SiO2, Ta, Ta2O5, Ti, TiN, TiO2, W
- 設備状況
- 稼働中