共用設備検索結果
表示件数
ウェット処理・洗浄装置 (Wet bench)
- 設備ID
- TH-101
- 設置機関
- 豊橋技術科学大学
- 設備画像

- メーカー名
- ダルトン, クレセン, セミツール, レグザム, カナメックス (DALTON, Clesen, Semitool, Rexxam, Kanamex)
- 型番
- ECS-1, DF-1, ECD-3000BEW, CWC4+4M, SRD270(改), SCRD4, KES-200NP2
- 仕様・特徴
- 【無機ドラフタ(DF-1, ECD-3000BEW)】
RCA洗浄、DHF、BHF、混酸等の調合、昇温、ウェハ処理、DIW水洗、スピン乾燥またはN2ブロー乾燥が可能
【無機洗浄バッチ層(クレセン)】
4インチウェハ1ケース(25枚)単位でのRCA洗浄およびDHF処理、DIW水洗が可能。
【有機ドラフタ(ECS-1)】
イエロールーム内に設置。リソグラフィ後の現像処理が可能。DIW使用可能。N2ブロー可能
【マスク加工装置(KES-200NP2)】
マスク製作時のクロムエッチングおよび硫酸過水によるレジスト剥離装置
【超臨界洗浄装置(SCRD4)】
MEMS稼働構造形成時の水洗後乾燥をCO2超臨界乾燥にて行える。φ4インチウェハサイズまで対応
- 設備状況
- 稼働中
金属成膜装置 (Metal Deposition System )
- 設備ID
- TH-201
- 設置機関
- 豊橋技術科学大学
- 設備画像
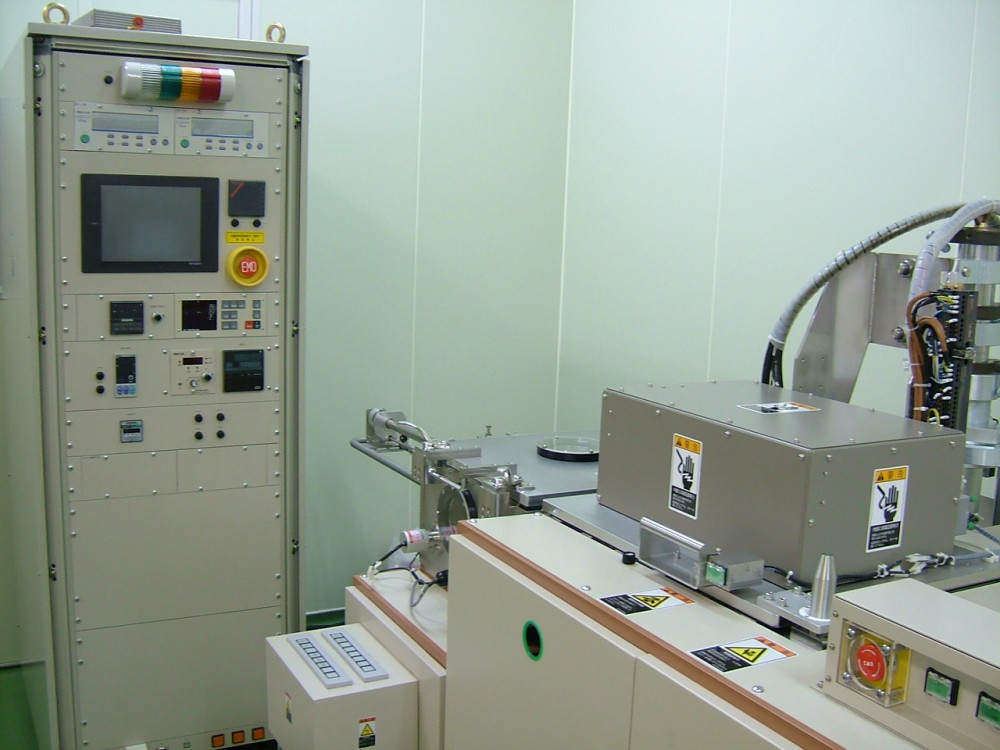
- メーカー名
- キヤノンアネルバ, ノイエス, サンバック (Canon Anelva, Noyes, SANVAC)
- 型番
- L-420S-FHL, E-400S, E-401S, RFS-400, ED-1600
- 仕様・特徴
- 各種金属材料の成膜
【L-420S-FHL】
方式:DCスパッタ、フェイスアップ
対応試料:φ4インチ3枚またはφ2インチ6枚まで
材料:純Al、Al-1%Si
【E-400S】
方式:DC/RFスパッタ、フェイスダウン
対応試料:φ4インチ3枚またはチップトレイ
材料:純Al、Al-1%Si、Ti、W、TiN(反応性スパッタにて)
【E-401S】
方式:RF、フェイスアップ
対応試料:φ4インチ3枚
材料:Al、Al-1%Si、Ti、TiN(反応性スパッタにて)、その他金属持ち込み可能
【ノイエス】
方式:RFガン、フェイスダウン
対応試料:φ4インチ以下
材料:Ti,Pt,Au,Ir その他金属持ち込み可能
【ED-1600】
方式:EB蒸着、フェイスダウン
対応試料:φ6インチ以下
材料:Au、Ti その他金属持ち込み可能
- 設備状況
- 稼働中
絶縁膜成膜装置 (Dielectric Deposition System)
- 設備ID
- TH-202
- 設置機関
- 豊橋技術科学大学
- 設備画像

- メーカー名
- キヤノンアネルバ, 日本パリレン (Canon Anelva, Parylene Japan)
- 型番
- E-401S, EB-1100, PDS2010
- 仕様・特徴
- 各種絶縁膜材料の成膜
【E-401S】
方式:RFスパッタ
対応試料:φ4インチ3枚
材料:Ta2O5
【EB-1100】
方式:RFスパッタ
対応試料:φ4インチ3枚
材料:SiO2、SiN
【PDS2010】
方式:抵抗加熱
対応試料:100mm角以下
材料:Parylene-C, N その他パリレン材料持ち込み可
- 設備状況
- 稼働中
LPCVD装置 (LPCVD system)
- 設備ID
- TH-221
- 設置機関
- 豊橋技術科学大学
- 設備画像
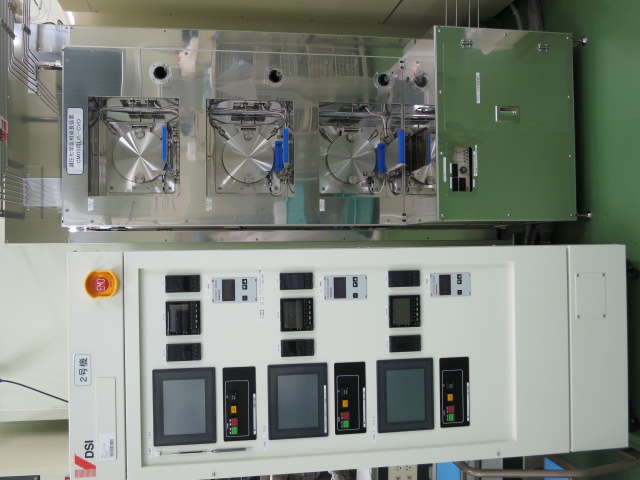
- メーカー名
- ディー・エス・アイ (DSI)
- 型番
- DJ-11S689-M
- 仕様・特徴
- 化学気相成長法により多結晶Si、Si窒化膜、Si酸化膜を形成する。
温度:500-850℃
対応基板:Siウェハ専用
基板サイズ:φ4インチ 以下
- 設備状況
- 稼働中
プラズマCVD装置 (Plasma Enhanced CVD system)
- 設備ID
- TH-222
- 設置機関
- 豊橋技術科学大学
- 設備画像
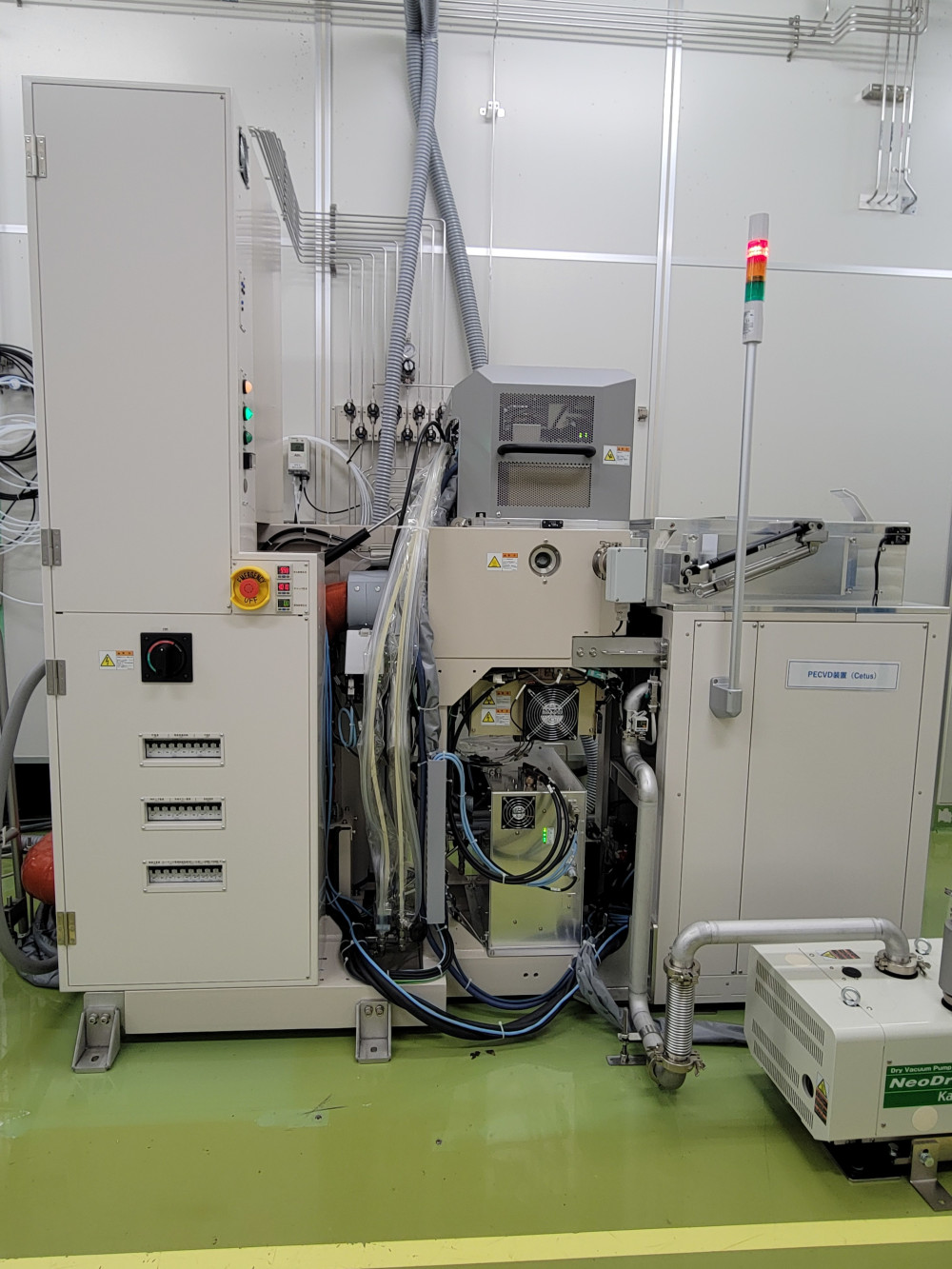
- メーカー名
- サムコ, SPPテクノロジーズ (Samco, SPP Technologies)
- 型番
- PD-220M, PD-220Ns, PD-220NLM, APX-Cetus
- 仕様・特徴
- 原料ガスをプラズマ化することでSi酸化膜やSi窒化膜等の化学気相成長を行う。
<使用ガス> SiOx:SiH4, N2O または TEOS SiN:SiH4, NH3 SiON:SiH4, N2O, NH3
【PD-220M, PDー220Ns】
対応膜:SiOx, SiN, SiON
対応試料:φ8インチ以下
【PD-220NLM】
ボロンドープ、リンドープ SiOx膜(BSG, PSG, BPSG)用
対応試料:φ8インチ以下、集積回路プロセス用
【APX-Cetus】
対応膜:アモルファスSi, SiOx, SiN, SiON
対応試料:φ8インチ以下
- 設備状況
- 稼働中
ドライ加工プロセス装置 (Dry etching system)
- 設備ID
- TH-301
- 設置機関
- 豊橋技術科学大学
- 設備画像
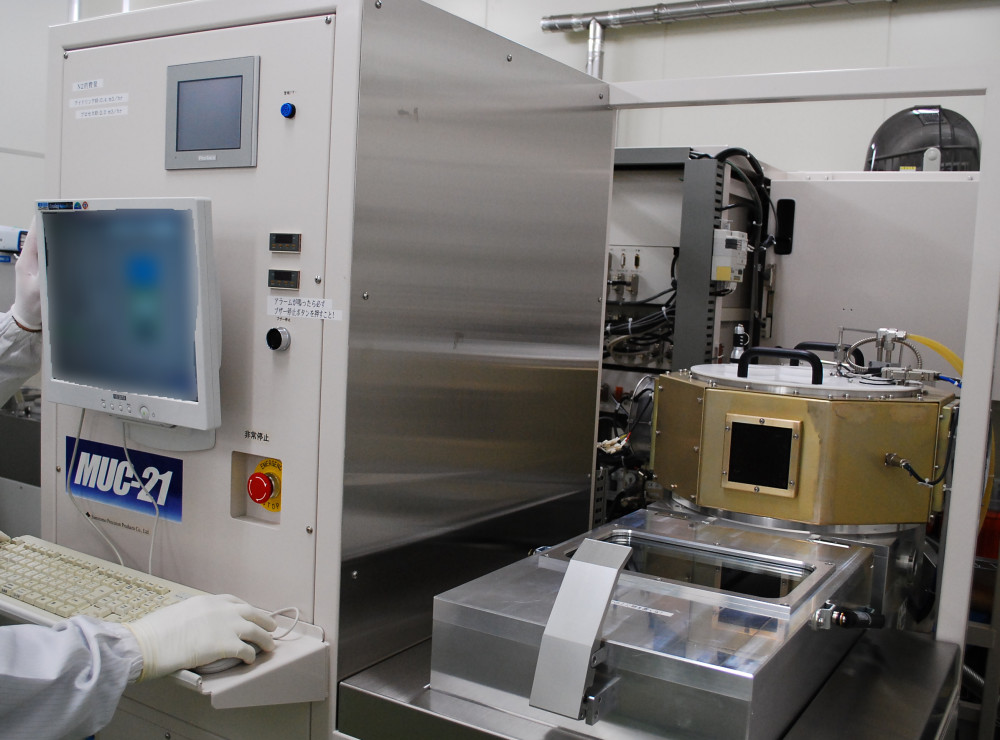
- メーカー名
- サムコ, キヤノンアネルバ, アルバック, SPPテクノロジーズ (Samco, Canon Anelva, ULVAC, SPP Technologies)
- 型番
- RIE-200NL, RIE-200F, RIE-101iPH, PX-250M, PC-1100, UV-300, UV-1, L-415D-L, CE-300I, APX-Sirius, MUC21-RD, Xetech E1
- 仕様・特徴
- 【RIE-200NL, L-415D-L】
プラズマ化したガスにより金属系材料を除去する。
プラズマ生成方式:平行平板型
使用可能ガス:Cl2, BCl3, CF4, CHF3, SF6, O2, N2
対応試料:φ8インチ以下
【RIE-200F, L-415D-L】
プラズマ化したガスによりSi系材料を除去する。平行平板型
プラズマ生成方式:平行平板型
使用可能ガス:CF4, CHF3, SF6, O2, N2
対応試料:φ8インチ以下
【APX-Sirius】
プラズマ化したガスによりSi系材料を除去する。
プラズマ生成方式:ICP型
使用可能ガス:CF4, CHF3, SF6, O2, N2
対応試料:φ4インチ専用
【CE-300I】
プラズマ化したガスにより酸化物および貴金属材料の除去を行う。
プラズマ生成方式:ICP型
使用可能ガス:Ar, Cl2, BCl3, CF4, CHF3, C4F8,(組み合わせに制限有り)
対応試料:φ4インチ専用
【RIE-101iPH】
り難加工性の高い窒化物半導体(GaN)系材料のエッチングを行う。
プラズマ生成方式:ICP型
使用可能ガス:Cl2, SiCl4
対応試料:φ4インチおよび小片チップ
【MUC21-RD】
ボッシュプロセス装置
対応基板:φ4インチ Siウェハ専用
【Xetech E1】
XeF2ガスによりSiを選択的に除去する。
対応基板サイズ:φ4インチ 以下
【PX-250M、PC-1100】
酸素プラズマとCF4ガスによるレジストを除去。O2ガスプラズマによる表面改質
使用ガス:O2, CF4
【UV-1, UV-300】
UV・オゾンにより試料表面の改質処理を行う。
使用ガス:O2
- 設備状況
- 稼働中
酸化・熱処理装置 (Oxidation/Thermal Processing System)
- 設備ID
- TH-401
- 設置機関
- 豊橋技術科学大学
- 設備画像
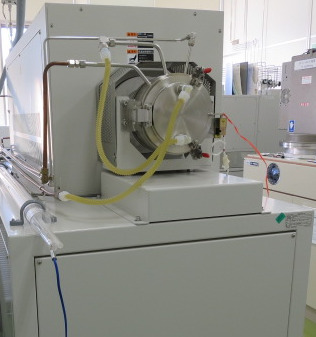
- メーカー名
- 光洋サーモシステム、光洋リンドバーグ(JTEKTサーモシステム) (JTEKT Thermo Systems)
- 型番
- Model 272H-300H15X070H, KTF-050N-PA, Model 272M, KTF773N-AS
- 仕様・特徴
- 酸素・水素・窒素ガス雰囲気中でSiウェハの酸化・熱処理を行う。
【272H】
パイロジェニック酸化対応炉4本、ドライ酸化対応炉2本
使用温度:800-1050℃(一部1150℃)
使用可能ガス:O2, N2, H2(炉によって制限あり)
対応基板:Si基板専用 φ4インチ 以下
【KTF-050N-PA】
使用温度:800-1050℃
使用可能ガス:O2, N2, H2(炉によって制限あり)
対応基板:φ4インチ 以下
【272M】
使用温度:400-700℃
使用可能ガス:N2, フォーミングガス
対応基板:φ4インチ 以下
【KTF773N-AS】
使用温度:400-700℃
使用可能ガス:N2, フォーミングガス
対応基板:Si基板専用 φ4インチ 以下
- 設備状況
- 稼働中
不純物ドーピング装置 (Doping system)
- 設備ID
- TH-411
- 設置機関
- 豊橋技術科学大学
- 設備画像
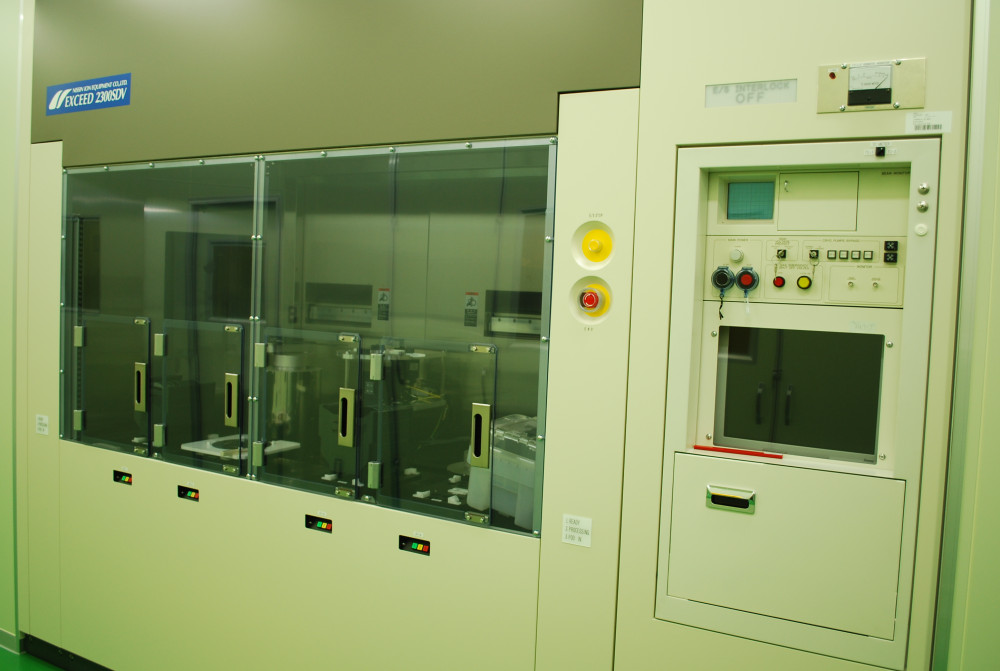
- メーカー名
- 日新イオン機器, 光洋リンドバーグ (Nissin Ion Equipment, JTEKT Thermo Systems)
- 型番
- EXCEED2300SDV, Model 272M
- 仕様・特徴
- 【EXCEED2300SDV】
イオンを高エネルギーで加速しウェハへ打ち込む装置。
注入可能イオン:B, BF2, P, Si
加速電圧:10-150kV
対応基板:20mm角~φ8インチ以下
【272M】
Siウェハを1,000℃以上に加熱し、リンを含むガスを流しウェハ内にリンを導入する。
使用温度:1040℃
使用ガス:POCl3(N2バブリング), O2, N2
対応基板:Si基板専用 φ4インチ または φ2インチ
- 設備状況
- 稼働中
i線露光装置 (i-line lithography system)
- 設備ID
- TH-501
- 設置機関
- 豊橋技術科学大学
- 設備画像

- メーカー名
- ニコン, キヤノン (Nikon, Canon)
- 型番
- NSR-TFHi12CH, FPAー3030i5a
- 仕様・特徴
- i線の1/5縮小投影露光装置
【NSR-TFHi12CH】
対応基板:Si基板専用 φ4インチ
マスク仕様:5インチ(青板)
最大露光サイズ:20mm
【FPAー3050i5a】
対応基板:φ4インチ または φ6インチ
マスク仕様:6インチ(石英)
最大露光サイズ:22mm
特殊仕様:透明基板対応、裏面アライメント対応
- 設備状況
- 稼働中
コンタクト露光装置 (Contact lithography system)
- 設備ID
- TH-502
- 設置機関
- 豊橋技術科学大学
- 設備画像
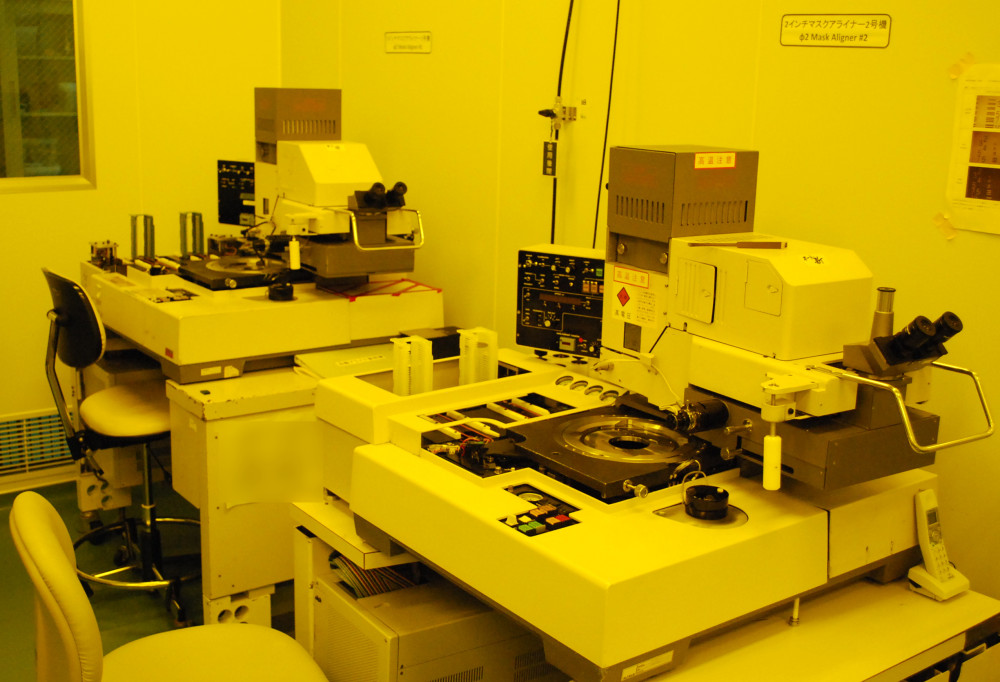
- メーカー名
- キヤノン, SuSS (Canon, Suss)
- 型番
- PLA-501(F), PLA-600, MA6 BSA
- 仕様・特徴
- 【PLA-501(F)】
自動ローディング機構付き2台、自動ローディング無し1台
光源:i~h
対応基板:φ2インチ
マスクサイズ:5インチ
特記事項:自動ローディング無し装置はφ2インチ以下も対応可能
【PLA-600】
光源:i~h
対応基板:φ4インチ
マスクサイズ:5インチ
【MA6 BSA】
対応基板:20mm角~φ4インチ
マスクサイズ:2.5インチ~5インチ
裏面アライメント可能
- 設備状況
- 稼働中